

발열 임계 넘은 AI 칩 대응 위해 구조개선·기술개발 가속
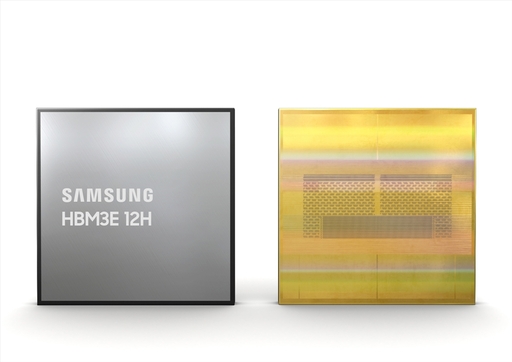
인공지능(AI) 반도체의 전력 밀도가 급격히 높아지면서 글로벌 반도체 기업들이 차세대 냉각 기술 확보에 속도를 내고 있다. 삼성전자와 TSMC를 중심으로 반도체 패키징 단계에서의 열 제어 효율을 높이기 위한 연구 경쟁이 본격화되는 모습이다.
11일 업계에 따르면 삼성전자와 TSMC는 AI 반도체의 발열 문제를 해결하기 위해 패키지 내부 열 분산 구조를 개선하는 기술 개발에 나서고 있다. 기존 공랭·수랭 방식의 한계를 해결하기 위함이다.
특히 삼성전자는 3D 적층형 HBM 패키지의 열저항을 낮추는 신소재 및 구조 개선 연구를 추진하고 있으며, TSMC는 실리콘 인터포저에 열전달 경로를 내장하는 고집적 패키징 구조를 공개한 바 있다.
삼성전자는 패키징 열관리 역량을 다방면으로 강화하고 있다. HBM3E 12단(12-Hi) 제품에 열전달 효율을 높이는 '열압착 비전도성필름(TC NCF)' 공정을 업계 최초로 적용해 12단 적층 구조에서도 열 성능을 확보했으며, 고성능 메모리의 발열 특성을 개선하기 위한 소재·구조 연구를 병행하며 차세대 HBM4 대응 기술 개발에도 속도를 내고 있다. 또 올해 5월에는 독일 산업용 냉각·공조 전문기업 플렉트그룹을 약 15억 유로(약 1조7000억 원)에 인수해 반도체 생산라인과 AI 데이터센터 등 고발열 인프라의 냉각 역량을 강화했다.
TSMC는 관련 기술을 학회와 컨퍼런스 등을 통해 적극적으로 공개하고 있다. IEEE ECTC에서는 인터포저 내부에 냉각 채널을 내장한 프로토타입을 소개하는 논문을 발표했으며, 세미콘 타이완 2024에서도 고집적 패키징의 열관리 혁신을 주제로 유체 기반 냉각 기술을 발표했다.
이 같은 움직임은 AI 반도체의 소비전력이 수백 와트 단위로 늘며 새로운 방식의 냉각 접근이 필요해진 데 따른 것이다. HBM4E 이후 공정에서는 메모리와 로직 칩이 밀착 적층되는 구조가 일반화되면서 패키징 단계에서의 냉각 효율이 성능 경쟁력의 핵심으로 부상했다.
최근 기술 경쟁은 단순한 특허 확보 단계를 넘어 특허 방어전의 연장선으로 해석된다. 삼성과 TSMC 모두 고대역폭메모리(HBM) 패키징 기술에서 시장 영향력이 큰 만큼 향후 열관리 구조가 표준화될 경우 특허권이 산업 전반의 협상 지위를 좌우할 가능성이 크다는 분석이다. 과거 노광(EUV)과 실리콘 관통전극(TSV) 분야에서 이어졌던 특허 경쟁이 향후 냉각 구조로 확장될 수 있다는 것이다.
특히 삼성전자의 경우 최근까지 글로벌 기업들과의 특허 소송이 이어지고 있어 '방어형 선점' 전략이 필요하다는 지적도 나온다. 실제로 삼성전자는 지난해까지 메모리 설계 및 패키징 분야에서 넷리스트, KIP 등과 다수의 분쟁을 겪었으며, 이달 초에는 미국 텍사스주 연방법원에서 유기발광다이오드(OLED) 관련 특허 침해로 1억9000만달러(약 2800억 원)를 배상하라는 평결을 받기도 했다.


 Copyright ⓒ 메트로신문 & metroseoul.co.kr
Copyright ⓒ 메트로신문 & metroseoul.co.kr
Copyright ⓒ Metro. All rights reserved. (주)메트로미디어의 모든 기사 또는 컨텐츠에 대한 무단 전재ㆍ복사ㆍ배포를 금합니다.
주식회사 메트로미디어 · 서울특별시 종로구 자하문로17길 18 ㅣ Tel : 02. 721. 9800 / Fax : 02. 730. 2882
문의메일 : webmaster@metroseoul.co.kr ㅣ 대표이사 · 발행인 · 편집인 : 이장규 ㅣ 신문사업 등록번호 : 서울, 가00206
인터넷신문 등록번호 : 서울, 아02546 ㅣ 등록일 : 2013년 3월 20일 ㅣ 제호 : 메트로신문
사업자등록번호 : 242-88-00131 ISSN : 2635-9219 ㅣ 청소년 보호책임자 및 고충처리인 : 안대성